24 cuestiones que debes conocer sobre los transistores de alta movilidad electrónica… y que nunca te atreviste a preguntar
Autor: Antonio Fernández Sánchez es ingeniero electrónico y trabaja como Maintenance Site Manager en SIEMENS. Se graduó en Ingeniería Electrónica por la Universidad de Granada en 1997. Sus áreas de interés incluyen los dispositivos semiconductores de microondas, entre otras.
El presente artículo pretende servir de introducción general a la tecnología de los llamados HEMT o transistores de alta movilidad electrónica. Un HEMT es un tipo de transistor de efecto campo (FET) basado en una heterounión, una unión de dos semiconductores de diferente banda prohibida. Este dispositivo demostró mejorar el funcionamiento del MESFET8 (transistor FET de unión metal-semiconductor) y, debido a sus características que más adelante introduciremos, posee una gran variedad de aplicaciones en el campo de radiofrecuencia y microondas. Entre estas, destacan su uso en amplificadores de bajo ruido (low noise amplifiers, LNAs) así como en aplicaciones de potencia10.
La forma elegida para abordar este tema es la de pregunta–respuesta con el objetivo principal de conseguir que el texto sea de fácil acceso y comprensión, así como de servir de introducción general para aquellos que no estén familiarizados con la materia.
Por ello nos cuestionaremos desde conceptos básicos de física de semiconductores hasta cuestiones más específicas relacionadas con el funcionamiento de este dispositivo tan apasionante y de los elementos que lo componen. Dicho esto y sin más preámbulo, empezamos.
1. ¿Qué es un transistor de alta movilidad electrónica o HEMT?
El transistor de alta movilidad electrónica es un tipo de transistor de efecto campo (FET) basado en una unión de semiconductores con distinto bandgap (una heterounión); esta unión puede llegar a ser una estructura bastante compleja formada por capas de dichos semiconductores.
Los materiales con los que habitualmente se han fabricado los HEMT han sido arseniuro de galio, GaAs y arseniuro de galio aluminio, AlGaAs. Este dispositivo fue desarrollado como sustituto del MESFET de GaAs (transistor FET de unión metal-semiconductor) para mejorar su funcionamiento8. El MESFET ha sido empleado normalmente en amplificadores de microondas durante los años 80 y 90. Podríamos afirmar por tanto que un HEMT es una variante de alto rendimiento del MESFET.
2. ¿De qué otras formas podemos nombrar a un HEMT?
Un transistor de alta movilidad electrónica o HEMT también puede ser encontrado en la bibliografía de las siguientes formas11,13:
- TEGFET: Two-dimensional Electron Gas Field-Effect Transistor
- MODFET: MOdulation Doped Field-Effect Transistor
- HFET: Heterojunction Field-Effect Transistor
3. ¿Quién desarrolló este dispositivo por primera vez?
En el año 1979 fue el Dr. Takashi Mimura y su grupo de FUJITSU Laboratories los primeros que desarrollaron con éxito el dispositivo HEMT. El Dr. Takashi Mimura se graduó en 1970 en la Graduate
School of Engineering Science de la Universidad de Osaka, donde recibió su doctorado en ingeniería en 1982.3,19
4. ¿Cómo es la estructura física de un HEMT?
El HEMT es un transistor de efecto campo en el cual la conducción no se produce en un canal bajo la puerta, como en un FET convencional, sino que se basa en una delgada capa con gran concentración de electrones llamada 2DEG (two-dimensional electron gas).
Como vemos en la figura 1, un HEMT convencional consiste en la siguiente estructura de capas8:

Fig. 1 Estructura de un HEMT convencional
- Una capa de AlGaAs dopada con átomos donadores (tipo n) de silicio Si (barrier layer o charge supply layer): actúa como donadora de electrones libres al canal.
- Una capa separadora de AlGaAs no dopado (spacer layer)8.
- Una capa de GaAs no dopado (channel layer): esta capa también podría estar compuesta por GaAs tipo p. Esta capa se hace crecer sobre un sustrato semi-aislante de GaAs.
- Terminales de fuente (S) y drenador (D): se difunden capas altamente dopadas de GaAs (contactos óhmicos), con la idea de que las resistencias de acceso desde estos terminales D y S sean lo más pequeñas posibles.
- Contacto de puerta (G): consiste en una unión Schottky (metal-semiconductor) similar a la existente en un MESFET, con características rectificadoras.
La superficie del dispositivo se somete a una pasivación o aislamiento mediante el depósito de dieléctrico8; en el caso de dispositivos de GaAs usamos nitruro de silicio Si3N4, ya que el GaAs no posee un óxido propio como es el caso del silicio.
Lo interesante de esta estructura es que bajo el contacto Schottky de la puerta tenemos una capa de semiconductor con bandgap ancho y debajo, una capa de semiconductor de bandgap menor:
- El bandgap del AlGaAs oscila entre 1,42 y 2,16eV (en función del contenido de aluminio, Al).
- El bandgap el GaAs es de 1,42eV.
En la siguiente figura vemos una estructura algo más completa de un HEMT, donde los contactos de drenador y fuente alcanzan la capa 2DEG16; asímismo, también podemos observar una capa buffer de GaAs situada entre el sustrato y la channel layer:
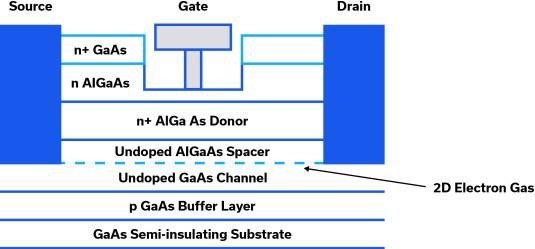
Fig. 2 Estructura más completa de un HEMT (Setty 2021, [16])
5. ¿Cómo funciona un HEMT?
En un HEMT los electrones de la capa dopada de AlGaAs tienden a difundirse hacia la capa de GaAs creando un canal de conducción cerca de la interfaz AlGaAs/GaAs, llamado gas electrónico bidimensional ó 2DEG. Aquí los electrones están confinados y se mueven en un plano bidimensional paralelo a la heterounión8,11.
Este gas de electrones bidimensional, de espesor nanométrico, constituye una capa de inversión electrónica11, es decir, una región donde la concentración de portadores minoritarios es mayor que la concentración de portadores mayoritarios en equilibrio. Si el semiconductor de menor bandgap está poco dopado (o sin dopar, como en el caso de la figura 1), la movilidad electrónica de la capa de inversión será grande. Esta capa 2DEG es por tanto la responsable de la conducción del dispositivo.
Debido a la separación de la capa de suministro de electrones (AlGaAs) y la capa no dopada, así como al confinamiento de los electrones en una interfaz extremadamente fina se consigue reducir la dispersión culombiana8 que frena a los electrones en su movimiento desde la fuente al drenador. Con ello conseguimos una alta velocidad y una alta movilidad electrónica.
6. ¿Qué implica una alta movilidad electrónica?
Implica tiempos de tránsito muy pequeños entre fuente y drenador, alta velocidad de funcionamiento y por tanto, frecuencias de operación muy altas. Esto hace a este dispositivo muy adecuado para su empleo dentro del rango de microondas.
7. ¿Cómo es la estructura de bandas de un HEMT?
El diagrama de bandas de energía de un HEMT clásico es el siguiente8,11:

Fig. 3 Estructura de bandas “simplificada” de un HEMT convencional
Debido a la diferencia de bandgaps podemos ver la discontinuidad existente entre la capa muy dopada de AlGaAs y la capa no dopada de GaAs. Por otra parte, la capa de inversión electrónica constituye lo que se denomina un pozo de potencial (pozo triangular en este caso) dentro del cual los niveles de energía de los electrones están cuantizados (E0, E1, E2)11. Como los electrones tienden a ocupar los estados más bajos de energía, se dirigen hacia este pozo de potencial y forman el 2DEG confinado en el canal.
8. ¿Cómo operamos este dispositivo?
La operación de este dispositivo sería similar al MESFET, es decir, controlamos la corriente entre fuente y drenador mediante una tensión que aplicamos a la puerta (G), la cual modula la conductividad de la capa de inversión. Con tensiones de puerta positivas aumenta la profundidad del pozo de potencial generando así una mayor concentración de electrones; es decir, aumenta la densidad de electrones en la capa 2DEG (sheet carrier density, ns)11.
La corriente de drenador (en un HEMT ideal) es proporcional a la anchura del canal wch , a la densidad de electrones en la capa 2DEG (ns) y a la velocidad de saturación vsat, tal y como vemos en la siguiente expresión11:
![]()
9. ¿En qué consiste el concepto de modulación del dopado?
En una heterounión como la del sistema AlGaAs/GaAs de un HEMT tenemos un material de alto bandgap muy dopado (AlGaAs); en equilibrio los electrones asociados a las impurezas donadoras del AlGaAs ven estados de menor energía en el material de menor bandgap, produciéndose una transferencia de dichos
electrones al GaAs. Adicionalmente la separación que surge entre donadores cargados positivamente y electrones crea un campo eléctrico, el cual da lugar a una curvatura de las bandas de energía.
Este es el concepto de modulación del dopado8: en otras palabras, impurifico el AlGaAs para aportar los portadores necesarios, dejamos una región (spacer layer) sin dopar y no dopo el GaAs para reducir la dispersión culombiana y aumentar la velocidad de los portadores.
10. ¿Qué ventajas conseguimos con la modulación del dopado?
Conseguimos solucionar dos problemas: la dispersión de electrones libres y el carrier freeze-out. Veamos ambos en detalle.
Por una parte, está el problema de la dispersión de los electrones libres (coulomb scattering). Las impurezas ionizadas en un semiconductor dan lugar a centros de carga fija11,13 que provocan dispersión de los electrones libres; según hemos explicado antes, con la separación que conseguimos entre los electrones y estos centros de dispersión ionizados, eliminamos y/o reducimos esta dispersión y más aún si incorporamos a la estructura una capa separadora no dopada (spacer layer), como explicaremos más adelante. Al no existir o reducir la dispersión, la movilidad electrónica aumenta drásticamente.
Por otra parte, solucionamos también otro problema existente con el dopado: el llamado carrier freeze- out. Para ello consideremos la gráfica siguiente, la cual muestra la densidad de electrones libres en función de la temperatura (en este caso en particular, para una muestra de Si con una concentración de impurezas donadoras de 1015cm-3):

Fig. 4 Densidad de electrones en función de la temperatura (Singh 2001, [18])
Podemos ver que a bajas temperaturas (freezeout range) lo que ocurre es que todos los electrones están confinados en los átomos donadores, de modo que hay muy poca densidad de electrones libres. A medida que aumenta la temperatura, la cantidad de donadores ionizados (es decir, de electrones que
abandonan los átomos donadores y se convierten en electrones libres en la banda de conducción) aumenta hasta llegar el punto en que todos los donadores están ionizados, de modo que la densidad de electrones libres se iguala a la densidad de donadores (este es el llamado régimen de saturación)18.
Debido a la modulación del dopado, los electrones se encuentran a niveles de energía bajos y permanecen móviles incluso a temperaturas muy bajas, por tanto, se puede conseguir densidades de electrones muy elevadas las cuales se mantienen a bajas temperaturas.
11. ¿Qué ocurre con los HEMT y las temperaturas criogénicas?
En radioastronomía se trata de detectar señales muy débiles emitidas por objetos muy lejanos a la Tierra, de modo que los receptores destinados a esta tarea deben ser muy sensibles: en otras palabras, el nivel de ruido que ellos mismos generen debe ser mínimo.
Estos dispositivos generan menos ruido si son enfriados y por ello normalmente están refrigerados a temperaturas muy bajas4. Estas son temperaturas llamadas criogénicas, por debajo de -150 °C.
Un HEMT trabajando a temperaturas criogénicas tendrá una mayor movilidad electrónica, menor ruido (se minimiza el ruido térmico (*) debido a las bajas temperaturas) y un funcionamiento mejorado.
Estas temperaturas criogénicas también se emplean en sistemas de comunicación por satélite y en instrumentación científica específica.
(*) Recordemos que, debido al movimiento aleatorio de los portadores de carga, cualquier dispositivo que se encuentra a una temperatura superior al cero absoluto (-273ºC) genera ruido térmico. La potencia de ruido térmico se expresa de la siguiente forma:
N=kTB
donde K= constante de Boltzmann (1,38×10-23J/K), T=temperatura (en grados Kelvin) y B= ancho de banda (en Hz) en el cual medimos el ruido.
12. Pero ¿cuál es el proceso por el cual se crea la capa 2DEG?
A continuación veamos en detalle el proceso de la formación de la capa 2DEG. El proceso de comprensión de la estructura de bandas de energía en un semiconductor puede llegar a ser poco intuitivo y abstracto; para el caso de un HEMT vamos a intentar explicarlo de la forma más sencilla posible. Para ello vamos a fijarnos en la siguiente figura (aplicada al caso particular de un HEMT de nitruro de galio, GaN):


Fig. 5 Proceso de formación de la capa 2DEG, caso de un GaN HEMT (Xiao-Guang 2015, [4])
Supongamos una capa de semiconductor AlGaN dopado (tipo n) sobre una capa de GaN sin dopar (Fig.5 a); en la capa de AlGaN se induce una polarización donde las cargas negativas estarían en la parte superior de esta capa y las cargas positivas se situarían en la interfaz entre ambos semiconductores; es decir, tendríamos un campo eléctrico presente dentro del AlGaN4.
Esta polarización provoca que las bandas de energía se inclinen volcándose hacia la interfaz AlGaN/GaN (Fig. 5b). Este mismo efecto lo tendríamos al aplicar un voltaje a esta estructura. Este campo aplicado hace que los electrones libres (parte izquierda) fluyan hacia el polo positivo del campo (parte derecha) y dejando cargas positivas en el polo negativo. Estas cargas positivas y negativas crean un campo eléctrico que reduce el campo inicial, dando lugar a que la pendiente de las bandas de energía se redondee y el nivel de Fermi se estabilice, tal y como se ve en la Fig. 5c
Al unir la capa AlGaN con una capa de semiconductor de menor bandgap (Fig. 5d), el nivel de Fermi tiende a alinearse entre ambos de modo que los electrones acumulados en la parte “baja” del AlGaN fluyen hacia la parte superior del GaN, dando lugar a la capa 2DEG (Fig. 5e)4.
Esta capa constituye un pozo de potencial triangular11 donde los electrones se pueden mover rápidamente y de donde no pueden escapar; existe una gran concentración de electrones de alta movilidad que, debido a que se encuentran dentro de una capa semiconductora no dopada, no hay impurezas con las que puedan colisionar.
13. En la estructura de un HEMT ¿qué función tiene la spacer layer?
La capa no dopada de AlGaAs permite establecer una separación entre impurezas y portadores de carga (distanciamos el canal de las impurezas) y podemos decir que “apantallamos” el campo eléctrico presente en la barrier layer reduciendo así el efecto de la dispersión con impurezas ionizadas11 y mejorando la movilidad electrónica.
14. ¿Cuál es el principal problema que se presenta en un HEMT convencional?
El mayor problema es la presencia de lo que llamamos centros DX (o centros profundos) en mitad del bandgap de la capa barrier layer de AlGaAs. Para dopar esta capa se usa Si como donador, lo que da lugar a unos estados dentro del bandgap que atrapan electrones libres (DX center trapping effect). Este
efecto se hace mayor a medida que se aumenta la concentración de aluminio (Al) en esta capa, limitándola a un valor entre el 20 y el 25%13. Esto perjudica a la cantidad de electrones que se inyectan a la capa 2DEG y hace que el HEMT de AlGaAs sea un dispositivo de baja cantidad de corriente.
Los centros DX están por tanto en relación con la interacción de los átomos de Al y de Si en la barrier layer de AlGaAs13.
15. ¿Qué soluciones existen para este problema?
Son varias las soluciones que se presentan para mejorar las anomalías debidos a centros profundos, a la baja potencia y demás inconvenientes. Se trata de las siguientes8,13:
- Emplear otro tipo de semiconductor para la barrier
- Tecnología pHEMT o HEMT pseudomórfico.
- Estructura
- Doble
- Super-redes.
Veamos a continuación en detalle cada una de estas soluciones.
16. ¿Por qué emplear otro tipo de semiconductor para la barrier layer?
Si introducimos indio (In) en un dispositivo HEMT, es decir, si utilizamos InAlAs en lugar de AlGaAs (barrier layer) estaremos libres de centros DX. Esto implica a su vez sustituir la capa de GaAs por InGaAs y hacer crecer toda la estructura sobre un sustrato de InP para conseguir la adaptación de las redes cristalinas13.
La capa donde se produce la conducción (2DEG) es por tanto de InGaAs: este material posee una movilidad electrónica en torno a 10.000cm2/Vs, la cual es muy alta y superior a la del GaAs (que está en torno a 8500cm2/Vs). Esta característica confiere al dispositivo unas excelentes propiedades de movilidad electrónica tanto a temperatura ambiente como a muy bajas temperaturas.
Adicionalmente, aplicar un dopado muy elevado de la barrier layer de InAlAs (técnica delta-doping o planar-doping)13 proporciona altas densidades de electrones al canal. En la siguiente figura podemos ver un ejemplo de InP HEMT:
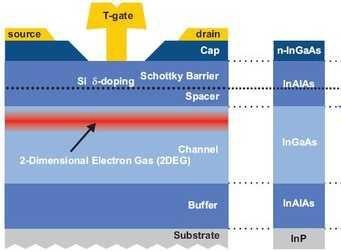
Fig. 6 Estructura de un HEMT de InP (ETH Zürich, MWE, [2])
En esta estructura podemos observar que el terminal de puerta se ha diseñado con forma de “T”, lo que permite reducir la resistencia de puerta al aumentar la sección transversal de la misma. Este diseño también proporciona una menor longitud de puerta2.
17. ¿En qué consiste la tecnología pHEMT o HEMT pseudomórfico?
El llamado pHEMT o HEMT pseudomórfico consiste en incorporar una capa muy delgada de InGaAs entre la capa de AlGaAs dopada (barrier layer) y la capa de GaAs no dopada (channel layer). Ya que esta capa tiene un bandgap menor que el GaAs, se forma un pozo de forma artificial donde los electrones se moverán. Las ventajas de esta estructura son una mayor movilidad electrónica y mayor velocidad de saturación.
La razón de emplear una capa muy delgada reside en la diferencia entre la constante de red del InGaAs y el GaAs, diferencia que dificulta el crecimiento de la primera sobre la segunda13. Recordamos que la estructura atómica más pequeña que podemos definir en un semiconductor es la llamada celda primitiva, la cual sería un cubo de dimensiones o lado “a”, llamada constante de red16.
El GaAs posee una constante de red de 5,65Å (angstroms) mientras que la del InGaAs puede oscilar en función de la proporción de In. Esta diferencia entre las constantes de red se soluciona si hacemos crecer solamente una capa muy fina y estirada (strained), que adopta la estructura de red del GaAs13. A esta capa epitaxial estirada que se adapta para adaptarse a la constante de red del sustrato le llamamos pseudomorphic layer, y es donde se confinan los electrones (2DEG).
La siguiente figura muestra gráficamente lo que hemos comentado:

Fig.7 Formación de la pseudomorphic layer (Setty 2021, [16])
Podemos hablar de pHEMTs basados en GaAs pero también de pHEMTs basados en InP. En la figura 7 podemos ver la estructura básica de un pHEMT basado en GaAs1:

Fig. 8 Estructura de un pHEMT basado en GaAs con puerta tipo “T”
18. ¿En qué consiste una estructura invertida en un HEMT?
En un HEMT con estructura invertida le damos la vuelta al orden de las capas, tal y como vemos en la figura 98. Con esto aproximo el canal 2DEG a la puerta y los electrones que pueda haber en el sustrato no pasarán al canal. Esto permite aumentar la capacidad de corriente y una mayor transconductancia, pero sin embargo también obtenemos una mayor capacidad de puerta así como una menor frecuencia de transición, fT..

Fig. 9 HEMT de estructura invertida
19. ¿En qué consiste un HEMT con doble 2DEG?
Para aumentar la potencia del dispositivo puedo disponer de un HEMT original al que añadimos otra capa de AlGaAs dopada debajo del GaAs no dopado, obteniendo así una channel layer con doble 2DEG comprendida entre 2 capas de AlGaAs8.
El resultado es una mayor densidad de electrones y corrientes más elevadas para la misma tensión aplicada. El aumento de la corriente disponible permite aumentar la frecuencia de conmutación y, por tanto, las prestaciones del circuito.
20. ¿En qué consisten las super redes?
Si en la estructura anterior de doble 2DEG sustituimos la capa de AlGaAs dopado por una super red (superlattice) se consiguen mejores prestaciones. La super red consiste en una sucesión de capas finísimas y alternadas de AlGaAs intrínseco sobre de GaAs dopado8, o bien, de AlGaAs intrínseco sobre GaAs intrínseco.
En la siguiente figura podemos ver un esquema básico de un HEMT basado en super redes8:
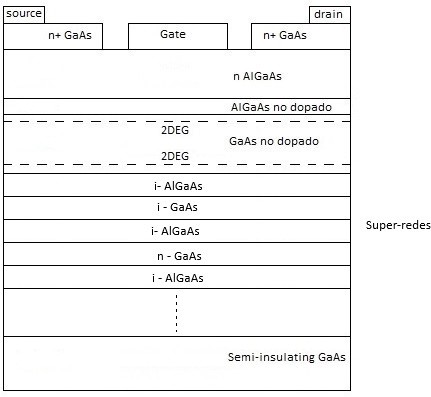
Fig. 10 Estructura simplificada de un HEMT basado en super redes
Veamos a continuación un poco más en detalle algunas características y/o ventajas de las super redes:
- En una super red los electrones atraviesan o se propagan a través de las distintas capas de la misma forma que lo hacen a través de la estructura atómica de un semiconductor13.
- Como veíamos anteriormente, el problema de los centros DX limita el suministro de electrones a la capa 2DEG; mediante el uso de super redes reducimos este problema ya que separamos físicamente los átomos donadores de Si de los átomos de Al.
- En esta estructura tipo sandwich de AlGaAs/GaAs/AlGaAs, los electrones se encuentran en el pozo formado por la capa central de donde no pueden escapar, ya que la profundidad de este (en eV) es mucho mayor que la energía térmica de los electrones (25meV, a temperatura ambiente). Sin embargo, si la barrera AlGaAs es lo suficientemente estrecha los electrones pueden atravesarla por efecto túnel para llegar a la capa 2DEG (electron tunnelling)13.
- El pozo descrito posee una serie de estados o niveles de energía desde y hacia donde los electrones se pueden mover y esto ocurre cuando los electrones se confinan en un espacio muy pequeño, de dimensiones atómicas13.
21. ¿Cuáles son las aplicaciones más frecuentes de un HEMT?
Tal y como hemos comentado anteriormente, en los dispositivos HEMT las características intrínsecas de alta movilidad electrónica los hacen ideales para aplicaciones de comunicaciones en el rango de microondas (1-30GHz) y ondas milimétricas (30-300GHz), es decir, sistemas de comunicación inalámbrica (teléfonos móviles, estaciones base de telefonía celular), sistemas de comunicación por satélite, receptores GPS, sistemas de radar y aplicaciones de guerra electrónica (electronic warfare, EW) entre otras.
Los HEMTs también se caracterizan por su bajo nivel de ruido, de modo que encuentran aplicación en el diseño de amplificadores de bajo ruido (LNAs) como, por ejemplo, en receptores de radioastronomía. Los HEMTS se emplean también en aplicaciones y amplificadores de potencia10.
22. ¿Cuáles son las aplicaciones más frecuentes de un pHEMT?
Los pHEMT (pseudomorphic high-electron-mobility-transistors) se emplean en la fabricación de circuitos integrados monolíticos de microondas (MMIC)16 debido a sus excelentes características como son entre otras, baja figura de ruido (noise figure), alto OIP3 (*) y excelente funcionamiento en frecuencias de microondas y superiores.
(*) OIP3: Output Intercept Point of the 3rd order. En un amplificador un alto OIP3 indica mejor linealidad, menos distorsión y menor generación de señales espurias.
Por último y aunque sea superficialmente, no podemos dejar sin mencionar la tecnología que desde hace unos años ha entrado en escena y ha revolucionado la electrónica de potencia y otros campos, desplazando al silicio en muchas aplicaciones. Se trata de los semiconductores de banda prohibida ancha (wide bandgap semiconductors o WBS a partir de ahora).
Este tipo de semiconductores se caracterizan por tener un bandgap mayor de 2eV; como comparación, el silicio posee un bandgap de 1,12eV. En relación con esta propiedad podemos establecer la siguiente clasificación12:
Tabla 1. Clasificación de los materiales según su bandgap
| Bandgap (eV) | Material | Ejemplos |
| 0 | Conductor | Cu, Al |
| < 2 | Semiconductor (elemento simple o semiconductor compuesto) | Ge, Si, InAs, InP, GaAs |
| >2 | Semiconductores WBS | SiC, ZnO, GaN |
| >4 | Aislante | Diamante |
Veamos a continuación algunas cuestiones importantes y cómo se aplican éstas a los HEMT.
23. ¿Por qué emplear WBS? ¿qué ventajas aportan sobre los dispositivos basados en silicio?
Sin duda los WBS más ampliamente conocidos y utilizados son el nitruro de galio (GaN) y el carburo de silicio (SiC). El primero es un semiconductor compuesto III-V (un elemento del grupo III y un elemento del grupo V de la tabla periódica) y el segundo es un semiconductor compuesto IV-IV (dos elementos del grupo IV).
En comparación con los dispositivos basados en silicio, las propiedades eléctricas y/o térmicas de los WBS son superiores. La siguiente tabla puede ayudarnos a responder estas preguntas.
Tabla 2. Características de los WBS
| Propiedad | Efecto-Resultado |
| Mayor band-gap |
Permite mayores temperaturas de funcionamiento |
| Mayor conductividad térmica | |
|
Mayor velocidad de saturación electrónica |
Menores pérdidas (Ron menor, resistencia en estado de conducción) |
| Mayores frecuencias de operación | |
| Mayor campo eléctrico de ruptura | Mayor voltaje de operación |
En la siguiente tabla podemos ver una comparativa de algunas propiedades de semiconductores como el GaN, SiC y GaAs en relación con el silicio5,17:
Tabla 3. Propiedades de algunos semiconductores conocidos
| Propiedad | Si | GaAs | GaN | 4H-SiC (1) |
| Movilidad electrónica (cm2/Vs) | 1400 | 8500 | 1500 | 900 |
| Band-gap (eV) | 1.12 | 1.42 | 3.39 | 3.265 |
| Densidad de potencia (W/mm) | 0.2 | 0.5 | >30 | 10 |
| Conductividad térmica (@300K) (W/cmK) | 1.3-1.5 | 0.5 | 1.3 | 4.9 |
| Campo eléctrico de ruptura Ec (kV/cm) | 300 | 400 | 3300 | 2200 |
(1) En el caso del carburo de silicio, el band-gap depende del tipo (polytype): el tipo más usado es el 4H-SiC.
24. Finalmente, GaN HEMTs
Abarcar esta tecnología en detalle requeriría la dedicación de libros enteros. En este apartado solamente vamos a señalar algunos puntos de interés. El nitruro de galio es un material muy resistente y mecánicamente estable. Como dispositivo de potencia sus características superan a sus equivalentes en silicio: entre otras, mayor tensión de ruptura (breakdown voltaje), mayor velocidad de conmutación15 y menor resistencia en estado de conducción (Ron).
Los dispositivos de GaN pueden crecer en distintos tipos de substratos: silicio, carburo de silicio, zafiro, diamante. Debido al coste del material y de los procesos, los GaN HEMT con sustrato de silicio (GaN-on- Si) podríamos definirlos como la versión de bajo coste. Por otro lado, los GaN HEMT con sustrato de SiC (GaN-on-SiC) permiten una mayor disipación térmica del calor ya que el SiC se distingue por su alta conductividad térmica15, como podemos observar en la tabla 3.
El tiempo de crecimiento (tiempo de producción de sustratos) del SiC es mucho más lento que en el caso del Si, de ahí que los GaN-on-SiC (en general) no destaquen por su uso comercial a gran escala, sino en aplicaciones especializadas como, por ejemplo, en defensa y aplicaciones de alta potencia.
Para finalizar, veamos algunos ejemplos de HEMT basados en GaN. En la figura 11 tenemos la estructura básica de un GaN HEMT, donde la capa 2DEG se crea en la interfaz entre GaN intrínseco y AlGaN:

Fig. 11 Estructura básica de un HEMT (Joshin 2014, [9])
Por último, en la figura 12 podemos ver la estructura de un GaN HEMT donde se incluye el llamado electrodo field-plate, estructura que consigue mejorar el funcionamiento eléctrico del dispositivo y permite aumentar el nivel de potencia (aumentar su rendimiento).
La función del field-plate es modular el campo eléctrico, reestructurar el perfil de distribución del campo eléctrico entre los terminales de puerta y drenador (en este caso en particular)20. Con ello se obtienen una serie de ventajas, como son entre otras, mayor tensión de ruptura y la reducción del efecto de atrapamiento de electrones en la superficie:
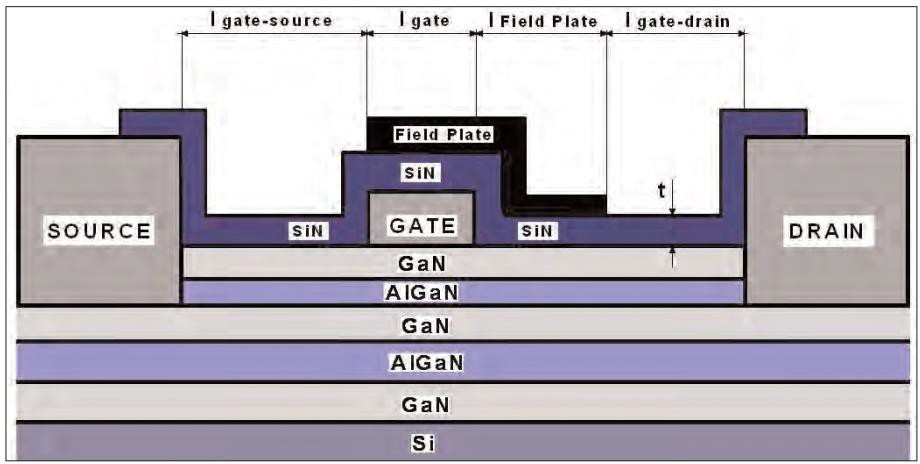
Fig. 12 Sección transversal de un GaN HEMT con electrodo field-plate (Vacca 2013, [20])
Referencias
- Es-Saqy, 5G mm-wave Band pHEMT VCO with Ultralow PN, Advances in Science, Technology and Engineering Systems Journal Vol. 5, No. 3, 487-492 (2020). https://www.researchgate.net/publication/342481729_5G_mm- wave_Band_pHEMT_VCO_with_Ultralow_PN_Published_in_Advances_in_Science_Technology_and_Engineeri ng_Systems_Journal_ASTESJ
- ETH Zürich. Millimeter-Wave Electronics laboratory (MWE). Indium Phosphide (InP) HEMTs, https://mwe.ee.ethz.ch/research/HEMT/InPHEMT.html
- Fujitsu Laboratories Ltd. Fujitsu Laboratories’ Honorary Fellow Takashi Mimura Honored with Kyoto Prize for HEMT Invention, https://www.fujitsu.com/global/about/resources/news/press-releases/2017/0616-01.html
- He Xiao-Guang, Zhao De-Gang, Jiang De-Sheng. Formation of two-dimensional electron gas at AlGaN/GaN heterostructure and the derivation of its sheet density expression. Chinese Physics B, 2015. https://cpb.iphy.ac.cn/article/2015/cpb_24_6_067301.html
- Hindle, 2010 GaAs Foundry Services Outlook, Microwave Journal Magazine, June 2010. https://www.microwavejournal.com/articles/9647-2010-gaas-foundry-services-outlook
- Instituto Geográfico Astronomía y Desarrollos Tecnológicos – Amplificadores Criogénicos de Bajo Ruido, https://astronomia.ign.es/amplificadores-de-microondas
- Jack Browne, Trying to Keep the Noise Down. Microwaves & RF Magazine, August 2017. https://www.mwrf.com/technologies/test-measurement/article/21848530/trying-to-keep-the-noise-down
- Jiménez Tejada, A. Dispositivos y circuitos integrados de microondas. Ingeniería Electrónica, Apuntes. Universidad de Granada, 1996.
- Joshin, , Kikkawa T., Mashuda S., Watanabe K. Outlook for GaN HEMT Technology, FUJITSU Sci. Tech. J., 2014. https://www.fujitsu.com/global/documents/about/resources/publications/fstj/archives/vol50-1/paper21.pdf
- Laverguetta, Thomas Microwaves and wireless simplified, 2nd edition. Artech House, 2005.
- Luy, Johann-F. Microwave Semiconductor Theory, Technology and Performance. Expert Verlag, 2006.
- Mouser, Reference Guide to Wide Bandgap Semiconductors, Mouser Electronics Inc., 2023. https://emea.info.mouser.com/greatscott-referenceguide-library?pid=greatscott&cid=youtube
- Orton, Semiconductors and the Information Revolution: Magic Crystals that made IT Happen. Elsevier, 2009.
- Pengelly, Raymond S. A Review of GaN on SiC High Electron-Mobility Power Transistors and MMICs. IEEE Transactions on Microwave Theory and Techniques, https://ieeexplore.ieee.org/document/6156768
- Schweber, Cómo los HEMT de GaN pueden ayudarle a aumentar la eficiencia de la fuente de alimentación, DigiKey, 2023. https://www.digikey.es/es/blog/how-gan-hemts-can-help-you-increase-power-supply- efficiency?srsltid=AfmBOoqBJ_5MKPyP-IueMU-1u9X-4woR796G1nvfwCnSsvSw3I9KQeeH
- Setty, MMIC Technologies: Pseudomorphic High Electron Mobility Transistor (pHEMT), Mini-Circuits, 2021. https://blog.minicircuits.com/mmic-technologies-pseudomorphic-high-electron-mobility-transistor- phemt/
- Singh, Optoelectronics. An Introduction to Materials and Devices. McGraw-Hill International Editions. Electrical Engineering Series, 1996.
- Singh, Semiconductor Devices: Basic Principles. John Wiley & Sons Inc., 2001.
- The University of Revolutionizing the World of Communications through Transistors. Success Comes with its Fair Share of Challenges.https://www.osaka-u.ac.jp/en/news/storyz/storyz_alumni/201802_storyz04
- Vacca, GaN-based HEMT improvement using advanced structures. Semiconductor Today Magazine- Compounds & Advanced Silicon, Sept. 2013.https://www.semiconductor-today.com/features/PDF/SemiconductorToday_September2013-GaN-based.pdf








